[반도체공정]주사전자현미경(Scanning Electron Microscopy)
 등록일 / 수정일
등록일 / 수정일 페이지 / 형식
페이지 / 형식 자료평가
자료평가 구매가격
구매가격
- 2010.09.08 / 2019.12.24
- 17페이지 /
 pptx (파워포인트 2007이상)
pptx (파워포인트 2007이상) - 평가한 분이 없습니다. (구매금액의 3%지급)
- 1,700원
최대 20페이지까지 미리보기 서비스를 제공합니다.
자료평가하면 구매금액의 3%지급!
 1
1 2
2 3
3 4
4 5
5 6
6 7
7 8
8 9
9 10
10 11
11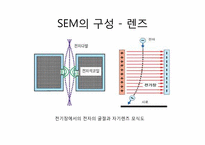 12
12 13
13 14
14 15
15 16
16 17
17
추천 연관자료
- 목차
-
1.주사전자현미경(SEM)이란?
2.SEM으로 얻을 수 있는 정보
3.SEM의특징
4.SEM과 광학현미경의 비교
5.전자빔과 시료의 상호작용
6.SEM의 분해능
7.SEM의 구성
8.SEM의 구성 - 전자총
9.SEM의 구성 - 렌즈
10.S.EM의 구성 - 조리개
11.SEM의 구성 – 샘플 Stage
- 본문내용
-
Topography 물체의 표면의 형상을 관찰
Morphology 물체를 구성하는 입자들의 형상과 크기 관찰
Composition 물체를 구성하는 원소와 화합물의 종류 및 상대적인 양을 분석
Crystallography 재료 내 원자들의 배열상태 분석
전자빔을 이용하여 전자가 시편과 충돌할 때 발생하는 이차전자, 반사전자, X-선 등을 검출하여 확대상을 촬영하는 장치
높은 분해능과 고배율 10~100만배
저배율도 관찰가능 10~100배
깊은 피사체 심도 요철이 심한 단면의 관찰이나 표면조도가 큰 시료를 관찰하는데 매우 유리
디지털 영상을 제공 영상의 저장은 물론 영상에 대한 다양한 분석이 가능
다양한 검출기 및 주변기기를 장착하여 응용분야를 확장
현미경의 내부는 진공상태 - 전자는 공기와 충돌하면 에너지가 소실되거나 굴절되는 등 원하는 대로 제어하기 어렵기 때문
배율 - 표본과 대물렌즈와 렌즈 사이의 거리는 일정, 중간렌즈와 투영렌즈의 코일에 통하는 전류의 세기에 의해 배율이 결정되며
초점 - 대물렌즈의 코일에 흐르는 전류에 의해 조절
상의 관찰 - 전자선이 시료의 표면에 충돌하면서 발생하는 이차 전자, 산란전자, 투과전자, X-Ray 등을 측정하여 표면의 형태를 영상으로 나타냄.
자료평가
-
아직 평가한 내용이 없습니다.










