[반도체] PE CVD(Plasma-Enhanced Chemical Vapor Deposition)
 등록일 / 수정일
등록일 / 수정일 페이지 / 형식
페이지 / 형식 자료평가
자료평가 구매가격
구매가격
- 2010.04.26 / 2019.12.24
- 19페이지 /
 ppt (파워포인트 2003)
ppt (파워포인트 2003) - 평가한 분이 없습니다. (구매금액의 3%지급)
- 1,800원
최대 20페이지까지 미리보기 서비스를 제공합니다.
자료평가하면 구매금액의 3%지급!
 1
1 2
2 3
3 4
4 5
5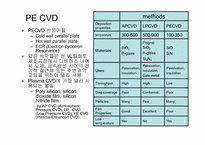 6
6 7
7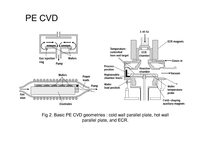 8
8 9
9 10
10 11
11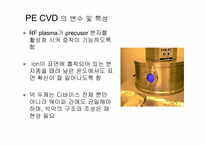 12
12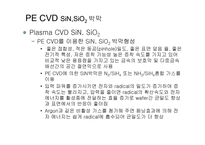 13
13 14
14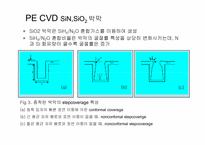 15
15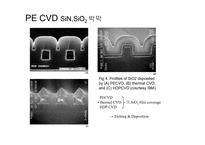 16
16 17
17 18
18 19
19
추천 연관자료
- 목차
-
Introduction
What is the PECVD
Plasma etching, Plasma Deposition
Plasma process for semiconductor
Plasma CVD
PE CVD mechanism
PE CVD의 7 step
PE CVD 변수 및 특성
PE CVD SiN, SiO2 박막
PE CVD W, WSI2 박막
Reference
- 본문내용
-
PE CVD
PE CVD공정은 Plasma etching 이 사용되기 이전부터 반도체 금속배선의 보호막인 SiN과 SiO2를 저온에서 증착할 수 있는 새로운 생성원으로 소개
PE CVD기술은 SiO2와 SiN 박막 형성 뿐만 아니라 최근에는 천이금속이나 천이금속 실리사이드 형성에도 널리 사용
PE CVD의 박막 형성 mechanism
Plasma 에서 이온과 radical의 형성
전형적인 PECVD조건에서는 전자의 에너지가 충분히 작아 이온화 속도보다 radical의 형성 속도가 빠름
Radical의 흡착
Radical은 높은 흡착계수를 가지고 있어 쉽게 표면에 흡착한 후, 가장 안정된 site 를 찾아 이동, 새로운 결합을 만들어 박막을 형성
표면에 붙은 원자의 재 분포의 화학적, 물리적 반응
외부공정 변수에 따라 가스상태에서 핵 형성 반응이 일어나기도 하고, plasma내의 불순물은 핵 site로 작용, 불필요한 먼지 입자를 생성
CVD의 7가지 step
(1)gas stream에서부터 wafer근처로의 precursor의 물질 전달
(2)중간 생성물의 형성
(3)중간 생성물의 wafer표면으로의 전달
(4)Si을 만드는 표면 반응
(5)기상 분해 생성물의 탈 착
(6)wafer로부터 gas phase stream으로 분해 생성물의 전달
(7)gas stream 에 의한 분해 생성물의 제거
PE CVD 공정변수
기판온도, 가스조성비, 가스유량, 압력, 입력파워, 고 주파수, 전극 간격
PE CVD에 의한 박막특성
증착속도, 박막조성비, 밀도, 굴절률, 막 두께의 군일도, 응력, 표면 덮음 율(step coverage), etching속도 등
저온에서 CVD를 해야 하는 경우 PECVD를 쓴다
Al 위에 SiO2를 증착하는 경우
GaAs 위에 Si3N4를 증착하는 경우
- 참고문헌
-
ATMOSPHERIC-PRESSURE PLASMA-ENHANCED CHEMICAL VAPOUR DEPOSITION (AP-PE-CVD) FOR GROWTH OF THIN FILMS AT LOW TEMPERATURE.
Martin J. Davis, Mihaela Tsanos
Institute for Materials Research, University of Salford, Salford, M5 4WT, UK
Chemical Vapor Deposition (CVD)
[ KAIST 미세전자 공정 수업자료 ]
반도체 공정 플라즈마 [장홍영]
STS PECVD Operating & Maintenance Manual
자료평가
-
아직 평가한 내용이 없습니다.










